
※ 流れに抗して――権謀と功利の渦巻く時代。孟子の遊説は梁に始ま
り、斉へ向かう。あいつぐ敗戦から立ちなおろうと富強政策に懸命
な梁の恵王、天下の郭者を夢みている野心家の斉の宣王、孟子はこ
れらの諸侯に向かって仁義と王道政治を説く。
性善説を唱え、民衆の真の幸福を仁義ある王道政治に求めた論客・
孟子。欲望のままに功利をむさぼり、激烈な権力闘争を続ける戦国
の世の中に対して、目先の利益のみを追う愚かさを説く。
※ ことば 「五十歩をもって百歩を笑わばいかん」
「仁者に敵なし」
「君子は庖厨を遠ざく」
「なさざるなり。能わざるにあらざるなり」
「木に縁りて魚を求むるがごとし」
「恒産なければ、よりて恒心なし」
「故国とは喬木あるの龍にあらざるなり。世臣あるの謂な
り」
「君子は、その人を養うゆえんのものをもって人を害せず」
【自然石の薪ストーブ】

※ 詳細は上写真ダブクリ
 No.75
No.75
【パワー半導体篇:電力損失世界最小のSiCパワー半導体素子 Ⅱ】
9月22日、三菱電機株式会社は、電流を高速遮断保護回路無しで使える、電力損失が世界最
小の炭化 ケイ素 (SiC)半導体素子の開発公表したことを掲載したが、今回は製造方法の参考
に下記の特許事例(株式会社日立製作所)を補足追加しておきその価値と開発課題を追加する。
❏ WO2016/084141 半導体スイッチング素子および炭化珪素半導体装置の製造方法
【概要】
炭化珪素(SiC)は、シリコンと比べてバンドギャップが大きく、絶縁破壊電界も1桁程度
大きいという特徴がある。このため、次世代のパワーデバイスとして有望視され、ダイオード
やトランジスタなど様々なデバイスの研究がなされている。特にSiC-MOSFET(MetAl-
Oxide-Semiconductor Field-Effect Transistor)は、高耐圧、低損失、高速スイッチングが理論的に
可能な素子であり、現在、主流となっているSi-IGBT(Insulated Gate Bipolar Transistor)
を置き換えることで電力損失を大幅に低減できると期待され、SiC-MOSFETの研究開
発が盛んに行われている。SiCはSiに比べてバンドギャップが広く、高い絶縁破壊強度を
有するが、その分SiC-MOSFETやSiC-IGBTではゲート絶縁膜にかかる電界が問
題となる。
このため、ゲート絶縁膜に掛かる電界に偏りが無い様、対称性の良い構造にする事が求められ
る。SiC-DMOSFET(Double-Diffused MOSTET)では、電流密度向上を目的に、チャネル幅(W)
を長くすることが求められる。チャネル幅(W)を長く出来、対称性の良い構造として、p型ベー
ス領域を矩形、六角形にして並べる構造や、p型ベース領域を長辺の長い矩形とし、p型ベース
領域の長辺端部同士を接続する構造が良く知られている。以下では、矩形のp型ベース領域を正
方格子状に並べて配置した構造をBOX構造と称し、p型ベース領域を長辺の長い矩形とし、p
型ベース領域の長辺端部同士を接続する構造をString構造と称す。
下図1はBOX構造における従来の一般的なSiC-DMOSFETのセルのパターン配置を
示す上面図である。p型ベース領域10、ソース領域20、ベースコンタクト領域11の位置
関係を示している。ここで(単位)セルとは、少なくともベース領域10とソース領域20を
備える単位をいうものとする。図2はString構造における従来の一般的なSiC-DM
OSFETのセルのパターン配置を示す上面図である。おなじく、p型ベース領域10、ソー
ス領域20、ベースコンタクト領域11の位置関係を示している。
 Jun. 2, 2015
Jun. 2, 2015
下図3は図1及び、図2のB-B’における断面図である。図3において、1は基板,2はド
リフト層,10はベース領域,11はベースコンタクト領域,20はソース領域,21はドレ
イン領域,32はゲート絶縁膜,33は層間膜,40はゲート材料膜,41はソースベースコ
ンタクト共通電極,42はドレインコンタクト電極,51はソースベース共通コンタクト、5
2はドレインコンタクトである。図3に示すようなSiC-DMOSFETは、n+型の炭化
珪素基板上1に、n-型ドリフト層2とp型ベース領域10をエピタキシャル成長やイオン注
入によって形成し、n+型のソース領域20とp+型のベースコンタクト領域11とn+型の
ドレイン領域21をイオン注入によって形成する。この様な炭化珪素基板に対し、熱酸化法や
堆積酸化膜を利用してゲート絶縁膜32を形成し、ゲート絶縁膜32を介してゲート電極を形
成する。更に、n+型のソース領域20とp+型のベースコンタクト領域11に接するように
、ソースベース共通コンタクト51と、ドレインコンタクト電極42と、層間膜33、表面保
護膜を形成する事で、SiC-DMOSFETが完成する。
下図4はBOX構造における電界集中点を示す。DMOSFETがオフの時、即ちゲート電極に
オン電圧以下の電圧が印加されており、ドレインコンタクト電極に電圧が印加されている場合、
図3、図4に示すように、BOX構造においては、セルに囲まれたJFET領域の中心に電界が集
中し、ゲート絶縁膜に掛かる電界強度が高くなる事が知られている。また、図2、図3に示す
ようにString構造においては、p型ベース領域に挟まれたJFET領域の中心線上に電界が集中し、
ゲート絶縁膜に掛かる電界強度が高くなる事が知られている。このゲート絶縁膜に掛かる電界
を緩和することを目的に、BOX構造における電界集中領域にp型やp+型の電界緩和領域を追
加する発明がある。
SiC結晶を電子デバイス用途で用いるためには、異なるポリタイプの混在がないSiC単結
晶のエピタキシャル成長技術が重要となる。品質の良いエピタキシャル成長技術としてステッ
プフロー成長法がよく用いられている。ステップフロー成長とは、例えば{0001}面等の結晶面
から数度(例えば4度、8度)のオフセット角(=オフ角)を導入した面に対して、エピタキシャル
成長を行う方法である。例えば図3の構成では、基板1表面にオフ角を導入し、その上にエピ
タキシャル成長を行う。
図5はステップフロー成長を用いたエピタキシャルウェハの表面形状を示す断面図である。図
5A、5Bに示すようにこのステップフロー成長を用いたエピタキシャルウェハには原理的に
オフ角が存在しており、{0001}面はウェハ表面に対してオフ角(例えば2度~8度、以下実施
例では主に4度を例にする)の分だけ傾いた左右非対称な結晶となっている。ウェハ表面(主
面)1800は幾何学的には、基板表面の最も低い点あるいは高い点を結んだ平面と考えることが
できる。なお、図5は原理図のため、実際の製品では面や角が、厳密な平面や角を構成してい
ない場合もある。実質的には、ウェハ表面の微細な凹凸を平均化あるいは無視した面と考える
ことができる。便宜的には、ウェハを例えば図3に示した板形状の物体として把握した場合、
その表面と考えればよい。以下では、最も面積の広い面(図5では{0001}面)を階段の踏み面
に見立て、階段の上段側をアップステップ側、下段側をダウンステップ側と呼ぶ。更に、アッ
プステップ側からダウンステップ側に向かう方向をオフ方向と定義する。
下図6は,2次元モンテカルロシミュレーションによる,アルミニウムイオン(Al+)の4H-
SiC基板上のエピタキシャル層への注入の計算機実験の結果。アルミニウムイオンは基板表
面に垂直に入射しているものとする。図5に示したようなオフ角に起因する結晶の非対称を考
慮し、イオン注入プロファイルの計算をおこなうと、イオン注入が深くなるにつれて、アップ
ステップ側よりもダウンステップ側のプロファイルの方が結晶内に広がる事が判った。これは、
エピタキシャル層の表面がオフ角をもつため,注入時にAl+イオンが受ける散乱の影響が[11-20]
方向と[-1-1-20]方向とで異なるためである。このAlの分布の拡がりの違いのために,[11-20]方
向の方が[-1-120]方向よりもマスクエッジの下方でのAlの濃度分布の曲率が大きくなり、注入後
のAlの拡散範囲が広い。これは、ゲート酸化膜にかかる電界の電界緩和効果がセルのアップス
テップ側よりもダウンステップ側の方が大きい事をしめす。
下図7は上記の電界緩和効果のかたよりによる、BOX構造における電界集中点のずれを示す。
平面図。下図8は上記の電界緩和効果のかたよりによる、String構造における電界集中点のずれ
を示す平面図。ゲート酸化膜にかかる電界が強くなる点は、例えば図7に示すBOX構造におい
ては、セルに囲まれたJFET領域の中心からダウンステップ方向へシフトする。図8に示すString
構造においては、p型ベース領域に挟まれたJFET領域の中心線上からダウンステップ方向へシ
フトする。ゲート酸化膜にかかる電界が強くなる点がダウンステップ方向へシフトする事によ
り従来構造ではゲート絶縁膜における耐圧の低下や、設計との相違が生じ、問題となる。本件
はこれらの課題をふまえ、耐圧特性に優れるSiC-DMOSFET及びSiC-IGBTを
提供する事にある。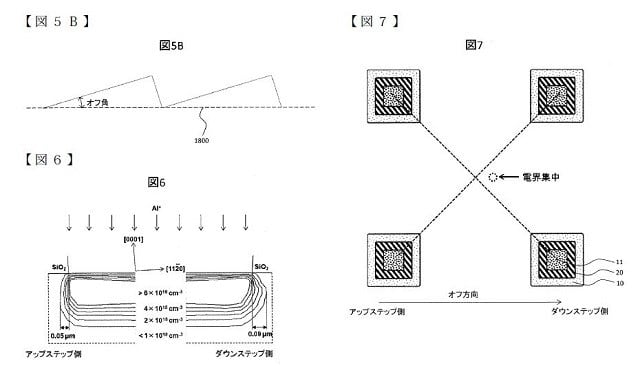

このため、第1導電型の炭化ケイ素半導体基板と、半導体基板の主面上に形成された第1導電
型のドリフト領域と、ドリフト領域の表層に形成された第2導電型のベース領域と、を備え、
第2導電型のベース領域の形状は、オフ方向と反対方向の第1導電型のドリフト領域の表面に
おける第2導電型の不純物注入領域の冶金学的境界の水平方向拡がり端において、第1導電型
のドリフト領域と第2導電型の不純物注入領域の冶金学的境界とがなす角度が90度未満とな
る特徴を備えることで問題を解決する(下図9参照)。このことで、炭化ケイ素を用いた半導
体装置およびその半導体装置の製造方法、ならびにその半導体装置を用いたパワーモジュール、
インバータ、自動車および鉄道車両に適用できる。
【符号の説明】
1 炭化珪素基板 2 炭化珪素層 10 ベース領域 11 ベースコンタクト領域 20 ソ
ース領域 21 ドレイン領域 30 マスク 32 ゲート絶縁膜 33 層間膜 40 ゲート
材料膜 41 ソースベースコンタクト共通電極 42 ドレインコンタクト電極 51 ソース
ベース共通コンタクト 52 ドレインコンタクト 60 電界緩和領域 100 第一のベース
領域 101 第二のベース領域 301 負荷 302 パワーモジュール 303 制御回路
304 SiC-MOSFET 305 ダイオード 306~312 端子 401負荷 402
パワーモジュール 403 制御回路 404 SiC-MOSFET 405~411 端子
501a 駆動輪 501b 駆動輪 502 駆動軸 503 3相モータ 504 インバータ
505 バッテリ 506 電力ライン 507 電力ライン 508 昇圧コンバータ 509
リレー 510 電子制御ユニット 511 リアクトル 512 平滑用コンデンサ 513
インバータ 514 SiC-MOSFET 601 負荷 602 インバータ 607 コンバ
ータ 608 キャパシタ 609 トランス OW 架線 PG パンタグラフ RT 線路
WH 車輪 
【特許請求の範囲】
- 第1導電型の半導体基板と、前記半導体基板上に形成された第1導電型のドリフト領域
と、前記ドリフト領域の表層に間隔を開けて形成された第1及び第2の単位セルと、前
記第1及び第2の単位セルに跨るように形成されたゲート絶縁膜と、前記ゲート絶縁膜
上に形成されたゲート電極を備え、前記単位セルの其々は、第2導電型のベース領域と、
前記ベース領域において表層にそのベース領域に囲まれるように形成された第1導電型
のソース領域と、を有し、前記ゲート絶縁膜は、前記第1の単位セルの前記ソース領域
の少なくとも一部、前記ベース領域の少なくとも一部、に被るように形成され、 前記
第2の単位セルの前記ソース領域の少なくとも一部、前記ベース領域の少なくとも一部、
に被るように形成され、前記ドリフト領域の少なくとも一部、に被る様に形成されてお
り、前記ゲート絶縁膜下における、前記ベース領域のオフ方向に沿った断面形状は、前
記ベース領域の、前記オフ方向と反対方向の、第2導電型の不純物注入領域の冶金学的
境界の水平方向拡がり端において、 前記ドリフト領域の表面近傍における、前記ドリフ
ト領域と前記第2導電型の不純物注入領域の冶金学的境界がなす角度が90度未満とな
ることを特徴とする半導体スイッチング素子。 - 前記ゲート電極下における、前記第2導電型の不純物注入領域である前記ベース領域の
水平方向拡がりが、アップステップ側の前記単位セルとダウンステップ側の前記単位セ
ルとで、略対称となることを特徴とする請求項1記載の半導体スイッチング素子。 - 前記半導体基板がn型4H-SiC基板であり、表面が(0001)面から[11-2
0]方向へ2度~8度オフしたことを特徴とする請求項1記載の半導体スイッチング素
子。 - 前記ベース領域は、前記第2導電型の不純物を前記基板表面に対して斜め方向に注入し
て形成されたことを特徴とする請求項1記載の半導体スイッチング素子。 - 第1導電型の半導体基板と、前記半導体基板上に形成された第1導電型のドリフト領域
と、前記ドリフト領域の表層に間隔を開けて形成された第1及び第2の単位セルと、前
記第1及び第2の単位セルに跨るように形成されたゲート絶縁膜と、前記ゲート絶縁膜
上に形成されたゲート電極を備え、前記単位セルの其々は、第2導電型のベース領域と、
前記ベース領域において表層にそのベース領域に囲まれるように形成された第1導電型
のソース領域と、を有し、前記ゲート絶縁膜は、前記第1の単位セルの前記ソース領域
の少なくとも一部、前記ベース領域の少なくとも一部、に被るように形成され、前記第
2の単位セルの前記ソース領域の少なくとも一部、前記ベース領域の少なくとも一部、
に被るように形成され、前記ドリフト領域の少なくとも一部、に被る様に形成されてお
り、 前記ベース領域は、前記ドリフト領域の表層に形成された第2導電型の第一のベ
ース領域と第2導電型の第二のベース領域を備え、前記第一のベース領域は前記第二の
ベース領域よりも浅い位置に形成され、前記第二のベース領域は、前記第一のベース領
域の下部に前記第一のベース領域と一部重なるように形成されていることを特徴とする
半導体スイッチング素子。 - 前記ゲート電極下における、前記第一のベース領域のオフ方向に沿った断面形状は、前
記第一のベース領域の、前記オフ方向と反対方向の、第2導電型の不純物注入領域の冶
金学的境界の水平方向拡がり端において、前記ドリフト領域の表面近傍における、前記
ドリフト領域と前記第一のベース領域の不純物注入領域の冶金学的境界とがなす角度が
90度以上となる特徴を有する請求項5記載の半導体スイッチング素子。 - 前記第二のベース領域のアップステップ側における前記ドリフト領域との冶金学的境界
は、前記第一のベース領域の前記ドリフト領域との冶金学的境界よりも、アップステッ
プ側に突出している特徴を有する請求項5記載の半導体スイッチング素子。 - 前記第一のベース領域と、第二のベース領域の境界付近における冶金学的境界に角部が
ある事を特徴とする請求項5記載の半導体スイッチング素子。 - 前記ゲート電極下における、前記第2導電型の不純物注入領域である前記ベース領域の
水平方向拡がりが、アップステップ側の前記単位セルとダウンステップ側の前記単位セ
ルとで、略対称となることを特徴とする請求項5記載の半導体スイッチング素子。 - 前記、第1導電型の炭化ケイ素半導体基板がn型4H-SiC基板であり、表面が(0
001)面から[11-20]方向へ4度~8度オフした特徴を有する請求項5記載の
半導体スイッチング素子。 - 前記第一のベース領域と第二のベース領域は、異なるマスクを用い、前記第2導電型の
不純物を前記基板表面に対して注入して形成されたことを特徴とする請求項5記載の半
導体スイッチング素子。 - 前記第一のベース領域は、前記ソース領域を形成するのに用いたマスクを用い、前記第
2導電型の不純物を前記基板表面に対して複数方向から斜め方向に注入して形成された
ことを特徴とする請求項5記載の半導体スイッチング素子。 - 第1導電型の炭化珪素半導体基板表面にステップフロー成長により第1導電型の炭化珪
素ドリフト層を形成する工程と、第2導電型のベース領域を形成する工程と、第1導電
型のソース領域を形成する工程と、第2導電型のベースコンタクト領域を形成する工程
と 第1導電型のドレイン領域を形成する工程と、を備え、2導電型のベース領域をウェ
ハ表面に対して斜めにイオン注入して形成する事を特徴とする炭化珪素半導体装置の製
造方法。 - 前記第2導電型のベース領域を形成する工程において、前記炭化珪素半導体基板として、
表面が(0001)面から[11-20]方向へ4度オフしたn型4H-SiC基板を
用い、前記第1導電型の炭化珪素ドリフト層の表面に、Alを[000-1]方向から
[-1-120]方向へ0度以上4度未満、または、[000-1]方向から[11-
20]方向へ0度以上12度以下の範囲の傾斜した方向にイオン注入する事を特徴とす
る請求項13記載の炭化珪素半導体装置の製造方法。 - 前記第2導電型のベース領域を形成する工程において、炭化珪素ドリフト層の表面に垂
直にイオン注入する工程と、斜めにイオン注入する工程を有することを特徴とする請求項
13記載の炭化珪素半導体装置の製造方法。
かって、『縄すてまじ』 で、自律型メガフロート型空港と空港と最寄り上陸ターミナ間の自動操縦型
ドローンシャトルの提案をしたが、後者の試作機が現実のものとなっている。凄い時代である(
詳細は上写真ダブクリ)。

読書録:村上春樹著『騎士団長殺し 第Ⅱ部 遷ろうメタファー編』
第53章 火掻き棒だったかもしれない
いくらか明るくはなったものの、相変わらずそこには匂いもなく物音もしなかった。やがて暗
くて狭い通路が終わり、私はほとんど唐突に開けた空間に足を踏み出した。頭上を見上げると、
そこには空はなかった。遥か高いところに乳白色の天井らしきものがあるようにも見えたが、正
確なところはわからない。そしてあたりはほんのりとした談い光で照らされていた。まるでたく
さんの発光虫が集まって世界を照らしているような不思議な光だった。もう真っ暗ではないこと
と、もう身を屈めなくてもよくなったことで、私はようやく一息つくことができた。
通路を出ると、足元はごつごつとした岩盤に変わっていた。遥というようなものはなく、ただ
岩盤に覆われた荒野が見渡す限り続いているだけだった。長く続いた下降は終了し、地面は今で
は緩やかな上り坂に変わっていた。私は足元に気を配りながら、どこに向かうというあてもなく、
ただ前方に歩を進めていった。腕時計に目をやったが、その針はもう何も意味していなかった。
それが何も意味していないことが私にはすぐ理解できた。私が身につけているほかのものもやは
り、そこではもう何の実質的な意味も持っていなかった。キー・リング、財布と運転免許証、い
くらかの小銭、ハンカチ、私か持っているのはせいぜいその程度のものだった。しかしその中に、
今の私を肋けてくれそうなものはひとつとして見当らなかった。
歩くにつれて坂の勾配は急になり、やがて両手と両足を使って丘の斜面を文字通りよじ登るよ
うな格好になった。その頂上まで登りきれば、あたりが見通せるようになるかもしれない。だか
ら息を切らせながらも休むことなく、斜面を登っていった。相変わらずどのような音も私の耳に
は屈かなかった。私か耳にするのは、自分の手足が立てる物音だけだった。そしてその音でさえ
どことなく作りもののようで、本当の音には聞こえなかった。見渡すかぎりそこには一本の樹木
もなく、草もなく、一羽の鳥も飛ばなかった。風さえ吹いていなかった。勤いているものといえ
ば、この私だけだ。まるで時が止まってしまったかのようにすべてが静止し、沈黙していた。
ようやく丘の頂上に登りつくと、予想していたとおり周囲一帯を広く見渡すことができた。し
かし一面に白っぽい霞のようなものがかかっていて、期待していたほど遠方までは見通せなかっ
た。私にわかったのは、少なくとも目の届く限り、そこは生命のしるしひとつ見えない不毛の上
地であるらしいということくらいだった。岩だらけのごつごつとした荒野がすべての方向に続い
ている。そして相変わらず空は見えない。乳白色の天井が(あるいは天井のように見えるもの
が)すっぽりかぷさっているだけだ。宇宙船の故障で、無人の未知の惑星に一人で降り立った宇
宙飛行士になったような気がした。そこに僅かなりとも光があり、吸える空気があることだけで
も感謝するべきなのだろう。
じっと耳を澄ませていると、何か微かな音が聞こえてくるような気がした。最初はただの錯覚
か、あるいは私の内部で生まれる耳鳴りのようなものかと思ったが、そのうちにそれが何らかの
自然現象が立てる継続的な現実の音であることがわかってきた。どうやら水の流れる音であるら
しい。あるいはそれが顔ながの言っていた川なのかもしれない。とにかく私は薄暗い光の中、水
音のする方に向けて、足元に注意しながら不揃いな斜面を下っていった。
水の音に耳を澄ませているうちに、ひどく喉が渇いていることに気がついた。考えてみればず
いぶん長いあいだ歩きっぱなしで、水分をまったくとっていなかった。でもおそらく緊張してい
たせいだろう、水のことなんて頭に浮かびもしなかった。しかし川の音を聞いていると、急にた
まらないほど水が飲みたくなってきた。とはいえ、果たしてその川の水は――もし音を発してい
るのが本当に川であったとすればだが――人間の飲用に適したものだろうか? 濁った泥水かも
しれないし、何か危険な物質や病原菌を含んだ水かもしれない。あるいは手では掬えない、ただ
のメタファーとしての水に過ぎないかもしれない。しかしとりあえず実際に行って確かめてみる
しかあるまい。
この項つづく
● 今夜の寸評:格差と分断
トランプ米国大統領法人税を15%への引き下げ、富裕層にかかる相続税は廃止する 3.8%分は
医療保険制度改革法(オバマケア)に当てる株式などへの譲渡益に課税するキャピタルゲイン税
は税率を23.8%から20%に下げと発表。同じく、マクロン仏大統領は、高額所得者に課す税金を
廃止する一方で、低所得者向けの住宅補助を削減を発表しているが、いずれも、富裕層の優遇に
つながり、社会の不平等を拡大させる「格差増大」「国民の分断」をさらに加速させ不安定さを
拡大させる憂慮である。































※コメント投稿者のブログIDはブログ作成者のみに通知されます